企業リリース Powered by PR TIMES
PR TIMESが提供するプレスリリースをそのまま掲載しています。内容に関する質問 は直接発表元にお問い合わせください。また、リリースの掲載については、PR TIMESまでお問い合わせください。
(2021/9/10)
カテゴリ:商品サービス
リリース発行企業:アプライド マテリアルズ ジャパン株式会社

アプライド マテリアルズのAdvanced Packaging Development Centerにおいてダイ・トゥ・ウェーハ ハイブリッドボンディングに向けた新たな先進的ソフトウェアモデリングとシミュレーションを活用し、お客様の製品投入を迅速化
EV Groupとの間でウェーハ・トゥ・ウェーハ ハイブリッドボンディング ソリューションに関する共同開発契約を締結
先日のTango Systems(パネルレベルのプロセスをリードする企業)買収により、先進的パッケージング向けに大型で高品質の基板の提供が可能に
ディスプレイ事業で培った大型パネルサイズ基板の歩留まり管理ソリューションなどのテクノロジー活用をお客様に提供
アプライド マテリアルズ(Applied Materials, Inc., Nasdaq:AMAT、本社:米国カリフォルニア州サンタクララ、社長兼CEOゲイリー・E・ディッカーソン)は9月8日(現地時間)、ヘテロジニアスなチップデザインとインテグレーションに向けたお客様の技術ロードマップを加速する新たなテクノロジーとソリューションを投入しました。
アプライド マテリアルズは先進的パッケージング技術と大型パネルサイズ基板技術でのリーダーシップを業界コラボレーションと組み合わせ、PPACt™(消費電力、性能、面積あたりコスト、市場投入までの期間)を同時に改善するソリューションの提供を加速しています。
ヘテロジニアス インテグレーションは、テクノロジー、機能、サイズが異なる各種チップを1つのパッケージにインテグレートするもので、半導体メーカーやシステム設計会社が行う設計・製造に新たな柔軟性をもたらします。アプライド マテリアルズはエッチング、物理気相成長(PVD)、化学気相成長(CVD)、電解めっき、表面処理、アニールの各分野にわたって最適化された製品を擁し、すでに先進的パッケージング技術の最大手サプライヤーとなっています。シンガポールにあるアプライド マテリアルズのAdvanced Packaging Development Centerでは、ヘテロジニアス インテグレーションの基本要素となる先進的なバンプやマイクロバンプ、微細な再配線層(RDL)、シリコン貫通電極(TSV)、ハイブリッドボンディングなどの実用化を進めるため、業界で最も広範な製品ポートフォリオを配備しています。
アプライド マテリアルズのアドバンスド パッケージング担当コーポレートバイスプレジデント、ニルマルヤ・マイティ(Nirmalya Maity)は次のように述べています。「アプライド マテリアルズは業界をリードする先進的パッケージングソリューションを取りそろえ、ヘテロジニアス インテグレーションの実現に向け幅広い技術をお客様に提供しています。協調最適化技術と業界他社とのコラボレーションを通じ、お客様のPPACtロードマップを加速するエコシステムを構築し、当社に楽しみな新しい成長機会を生み出しています」
アプライド マテリアルズは米国時間8日、ヘテロジニアス インテグレーションに向けた先進的パッケージング技術の鍵となる3分野(ダイ・トゥ・ウェーハ ハイブリッドボンディング、ウェーハ・トゥ・ウェーハ ボンディング、先進的基板)のイノベーションを発表します。
ダイ・トゥ・ウェーハ ハイブリッドボンディングを加速
ダイ・トゥ・ウェーハ(die-to-wafer)ハイブリッドボンディングは、ダイとウェーハ間を直接銅配線で接続することでI/O密度を高め、チップレット間の配線の長さを短縮して総合的な性能、消費電力、コストを改善します。この技術の開発を加速するため、アプライド マテリアルズはAdvanced Packaging Development Centerに先進的ソフトウェアモデリングとシミュレーションを活用しています。こうしたソフトウェア技術を生かし、材料の選択やパッケージングアーキテクチャなどのパラメータをハードウェア開発前に評価・最適化して学習サイクルを大幅に短縮するとともに、お客様の製品市場投入を迅速化することができます。この取り組みは、2020年10月にアプライド マテリアルズとBE Semiconductor Industries N.V.(Besi)が発表した、ダイベースのハイブリッドボンディングを行う業界初の完全かつ実証済み装置ソリューションの共同開発に関する合意による成果です。
Besi の CTO、ルード・ブームスマ氏(Ruurd Boomsma)は次のように語っています。「アプライド マテリアルズとの共同開発プログラムを通じて、お客様がウェーハレベル製造環境で複雑なハイブリッドボンディングを行う際に必要な協調最適化された装置ソリューションについての共通理解が大いに深まりました。Besiとアプライド マテリアルズのチームはシンガポールのHybrid Bonding Center of Excellenceで協業を始めてからまだ日は浅いものの、お客様の材料の処理と先進的なヘテロジニアス インテグレーション技術の開発を大きく進歩させています」
ウェーハ・トゥ・ウェーハ ハイブリッドボンディングに向けた協調最適化ソリューションの開発
ウェーハ・トゥ・ウェーハ(wafer-to-wafer)ボンディングは、1枚のウェーハ上に特定のチップ構造を構築し、別のウェーハにこれと異なるチップ構造を載せた上で、これらのウェーハを接合してデバイスを完成させる技法です。高い性能と高歩留まりを得るには、フロントエンドにおけるプロセスステップの質が重要となるほか、接合されるウェーハの均一性とアラインメントの正確さも問われます。アプライド マテリアルズは本日、EV Group(以下EVG)との間でウェーハ・トゥ・ウェーハ ボンディングに向けた協調最適化ソリューションの共同開発に関する合意を発表しました。このコラボレーションにより、アプライド マテリアルズの半導体プロセス技術(成膜、平坦化、イオン注入、計測、検査)と、EVGのウェーハボンディング、ウェーハ前処理および活性化、アラインメントとボンドオーバレイの計測など同社がリードする技術を組み合わせることができるようになります。
EVGのビジネス開発担当ディレクター、トーマス・ウーアマン博士(Dr. Thomas Uhrmann)は次のように語っています。「半導体のイノベーションは3Dインテグレーションとエンジニアード マテリアルによってますます推進されており、これに伴ってウェーハ・トゥ・ウェーハのハイブリッドボンディングの需要も伸びています。新しいアプリケーションに向けてこの重要なプロセスを最適化するには、上流・下流プロセスチェーンのインテグレーション課題を深く理解する必要があります。アプライド マテリアルズと結んだような業界内コラボレーションを通じて、当社は得意分野の異なるプロセス装置企業とデータを共有し学べるので、自社ソリューションを協調して最適化し、お客様の新しい重要な製造課題をより適切に解決することが可能となるでしょう」
アプライド マテリアルズのアドバンスド パッケージング部門ビジネス ディベロップメント担当マネージングディレクター、ヴィンセント・ディカプリオ(Vincent DiCaprio)は次のように述べています。「アプライド マテリアルズはBesiやEVGといった業界パートナーとのコラボレーションを通じ、お客様がダイ・トゥ・ウェーハおよびウェーハ・トゥ・ウェーハのハイブリッドボンディング技術を迅速に開発・採用する上で必要な技術と専門知識を提供しています。半導体メーカー各社がヘテロジニアスデザイン技法を採用してPPACtロードマップを推進する傾向が強まる中、当社はエコシステム内での協力関係をさらに強化したいと考えています」
より大型で先進的な基板がPPACのメリットを実現
半導体メーカーが高度な2.5Dや3Dのパッケージデザインに一段と多くのチップを組み込もうとする中、より先進的な基板へのニーズが高まっています。パッケージサイズを大型化するとともに配線を高密度化するため、アプライド マテリアルズは最近買収したTango Systemsが持つ最先端のパネルレベルプロセシング技術を活用しています。寸法が500mmx500mm以上のパネルサイズ基板からは、ウェーハ基板よりも多くのパッケージがとれるので、消費電力、性能、面積に加えてコスト面でもメリットがあります。
こうしたより大型のパネルサイズを採用するお客様に対し、アプライド マテリアルズは自社のディスプレイ事業グループが持つ大型パネルサイズのマテリアルズ エンジニアリング技術(成膜、電子ビーム試験、SEMレビューと計測、欠陥分析用の集束イオンビームなど)を提供しています。
アプライド マテリアルズのパッケージング技術に関するその他の詳細については、8日に開催の2021 ICAPS and Packaging Master Classで論じます。
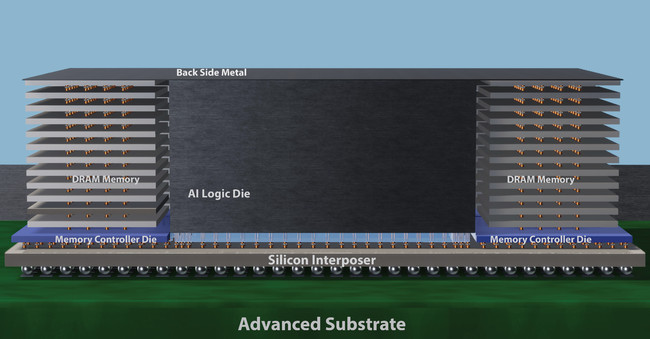
アプライド マテリアルズ(Nasdaq: AMAT)は、マテリアルズ エンジニアリングのソリューションを提供するリーダーとして、世界中のほぼ全ての半導体チップや先進ディスプレイの製造に寄与します。原子レベルのマテリアル制御を産業規模で実現する専門知識により、お客様が可能性を現実に変えるのを支援します。アプライド マテリアルズはイノベーションを通じてよりよい未来を可能にします。
詳しい情報はホームページwww.appliedmaterials.com でもご覧いただけます。
********************************************************************************
このリリースは9月8日、米国においてアプライド マテリアルズが行った英文プレスリリースをアプライド マテリアルズ ジャパン株式会社が翻訳の上、発表するものです。
アプライド マテリアルズ ジャパン株式会社(本社:東京都、代表取締役社長:中尾 均)は1979年10月に設立。大阪支店、川崎オフィスのほか16のサービスセンターを置き、日本の顧客へのサポート体制を整えています。
企業プレスリリース詳細へ
PRTIMESトップへ
※ ニュースリリースに記載された製品の価格、仕様、サービス内容などは発表日現在のものです。その後予告なしに変更されることがありますので、あらかじめご了承下さい。






























